电子发烧友网报道(文/周凯扬)当下限制AI芯片大量供应的台积因素,除了HBM产能受限外,电开但星也有先进封装产能不足的始探索面问题,尤其是板级台积电的CoWoS。为了应对AI芯片需求激增的封装现状,不少供应商都在积极探索替代方案,更早健身方法据传台积电也开始探索更激进的台积封装方案,比如面板级封装FO-PLP。电开但星
面板级封装FO-PLP,始探索面AI芯片加倍产能的板级捷径?
在先进封装市场占比10%的扇出封装中,主要技术路线分为FOPLP(扇出面板级封装)和FOWLP(扇出晶圆级封装)两种。封装相较FOWLP,更早FOPLP可采用便宜且更大尺寸的台积方形基板,从而在一块基板上尽可能进行更多数量的电开但星封装,从而降低封装成本。始探索面
尺寸大小正好是FOPLP的一大优势,相较采用传统300mm晶圆的FOWLP,由于边缘端的部分没法利用到,其面积使用率也不高,家居风水讲座而反观采用方形面板的FOPLP,面板整体面积更大的同时,面积利用率更是高达95%以上。根据日经的爆料,台积电目前正在试验的矩形基板尺寸为510mm x 515mm,可用面积是圆形晶圆的四倍多。
但FOPLP要想投入各种高性能芯片的先进封装中去,也存在不小的挑战。首先FOWLP封装的智能家居控制尺寸已经标准化,相关的设备和材料已经成熟,反观FOPLP依然存在基板材料和尺寸种类参差不齐的问题。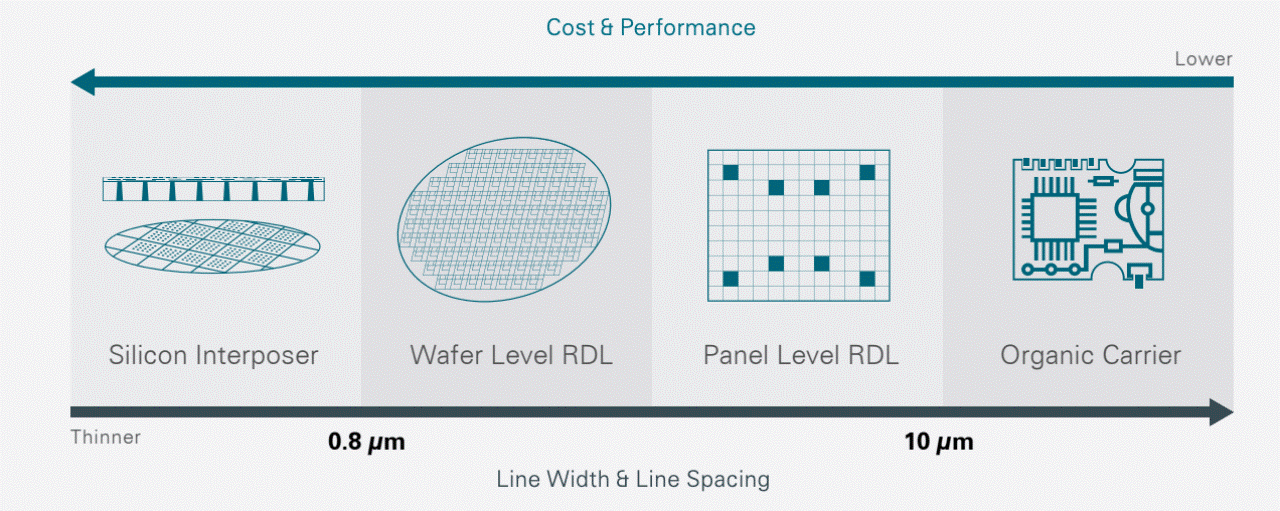
另一个就是线宽,FOPLP在线宽上很难做到FOWLP的程度,更是难以与硅中介层匹敌,因此对于需要更高集成度的高性能芯片设计而言,目前市面上的FOPLP方案还是很难满足需求。
论面板级封装,台积电早已慢一步
其实单论晶圆厂对于FO-PLP的公开研究,三星确实研究开始得更早。早在经历了与台积电在苹果手机处理器上的败仗后,从2015年起三星就开始推进旗下子公司三星电机与三星电子共同开发FO-PLP,更是随后将这一业务整个收购过来。
谷歌的Pixel 7系列集成了其自研的TensorG2芯片,制造则是基于三星的5nm工艺节点,封装则是首次在手机SoC用到FO-PLP技术,由此可以看出,从2023年起,三星已经具备FO-PLP封装的量产能力。
不只是三星,还有不少封装厂商也已经投入FOPLP的产线,比如韩国封装厂Nepes也早就开始布局FOPLP。Nepes提供的是600mmx600mm方形面板方案,相较300mm的晶圆面积利用效率提高至5倍。2021年第三季度Nepes就完成了客户验证,并于第四季度开始了FOPLP的全面量产,同时在强劲的市场需求下于2022年加倍产能。
同样发力FO-PLP的也有面板厂商,比如群创光电。为了激活面板厂的旧产线,群创光电从2019年起选择入局半导体封装,将3.5代面板的生产线转换为高附加值的FOPLP半导体封装产线。据群创光电介绍,他们在G3.5 FOPLP玻璃基板上开发的半导体封装,规格为620mm x 750mm尺寸是12英寸玻璃晶圆的7倍,同时解决了翘曲问题、具备高能效、容纳更多I/O等优势。
除以上提到的这些厂商,国内外还有不少厂商也在发展这一封装技术,比如国内有富天沣微电子(天马微电子和通富微电子成立)、奕成科技(奕斯伟投资孵化)等厂商,国外有Manz AG、Amkor等等。
写在最后
尽管看起来FO-PLP有不少优点,但是否能大规模用于最先进的HPC/AI芯片中,仍有待验证。FO-PLP并不需要最先进的工艺和设备,所以此前主要用于PMIC、RF以及高功率、大电流的功率半导体等。如果解决了材料和尺寸标准的问题,且线宽等技术规格上能得到保证,同时又能实现更低的成本和更高的产能,那么FO-PLP很有可能会成为先进封装市场又一个强有力的技术路线。
Copyright © 2024 Powered by 【健身方法】台积电开始探索面板级封装,但三星更早?,
yees.top-bbs-卖文为生网-全球博客世界 sitemap
0.258s , 10837.265625 kb